Microstructure diagnostics
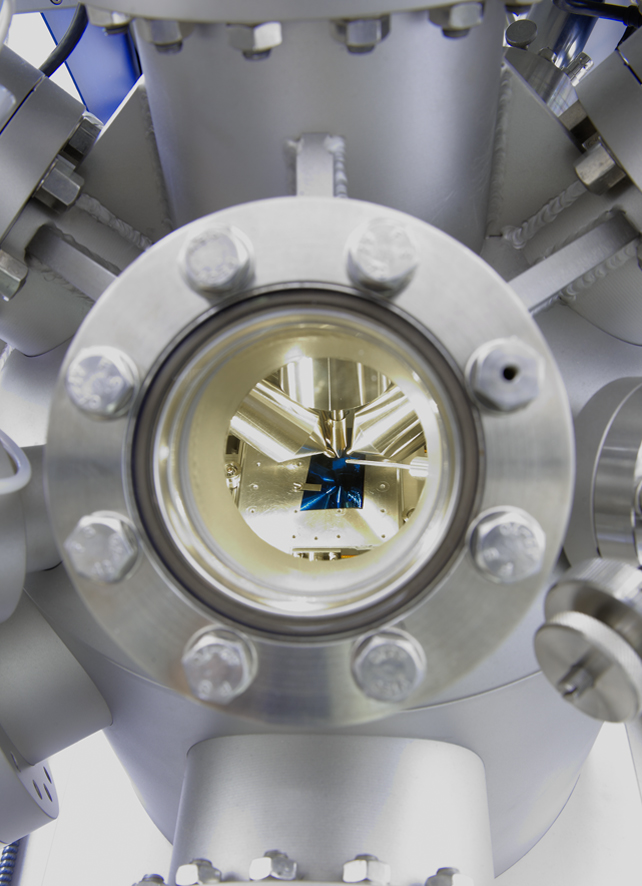
In the UHV chamber of the ToF-SIMS the chemical composition of a sample is determined with the aid of ion-sputtering sources.
- Metallography and ion beam assisted sample preparation
- Microscopy (optical, NIR)
- Analytical scanning electron microscopy (SEM) with EDX/EBSD, EBIC
- Transmissin electron microscopy (SEM) with EDX/EBSD, EBIC
- Focused ion beam (FIB)
- Time-of-flight secondary ion mass spectrometry (ToF-SIMS)
- X-ray photoelectron spectroscopy (XPS)
- Scanning probe microscopy (AFM)
- Scanning acoustic microscopy (SAM)