Unser Geschäftsfeld erforscht Komponenten, Systeme und Materialien der Elektronik und Mikrosystemtechnik, zum Beispiel integrierte Halbleiterschaltungen, Sensoren, elektronische Bauelemente und Baugruppen. Wir konzentrieren uns auf komplexe Fehlerdiagnosen für Feldrückläufer, auf die Verfolgung von Fehlerursachen in der Qualifikation oder in der Produktion und auf ein vertieftes Verständnis der Beziehung zwischen technologischen Prozess- und Anwendungsbedingungen mit Mikrostruktur und Materialeigenschaften sowie mit der betroffenen Funktionsleistung im Detail.
Leistungsangebote
Reiternavigation
Automotive Packaging
Fehleranalyse und Materialdiagnostik elektronische Systeme
Hier werden defektauslösende Faktoren identifiziert und die entsprechenden Versagensmechanismen nachvollzogen. Dies bietet die Grundlage für eine Steigerung der Zuverlässigkeit elektronische Systeme, denn sind diese bekannt, kann ein wirksamer Schutz entwickelt und das Ausfallrisiko minimiert werden.
Leistungen:
- Umfassende und zeiteffiziente Fehleranalysen für gehauste Komponenten und integrierte Baugruppen aus einer Hand
- Materialdiagnostik und Mikrostrukturanalyse von allen eingesetzten Materialien und Materialkombinationen
- Materialcharakterisierung und Fehleranalysen von elektronischen Packages (SiP, eWLB, PLP, MID, Embedded Components, Chiplets) und Systemen
- Beratung zu komplexen Ausfallphänomenen
- Analysen der Materialinteraktion für 2nd Level Reliability
- Materialcharakterisierung von neuen hochtemperaturstabilen Metallisierungs- und Leitersystemen sowie Verkapselungsmaterialien
- Modellierung und Simulation der mechanischen, thermischen und thermomechanischen Eigenschaften von Bauelementen
- Prozesscharakterisierung und -optimierung für Packaging- und Assembly-Technologien und Materialien durch Mikrostrukturanalyse, mechanische Prüfung, thermophysikalische und elektrochemische Materialdiagnostik
Angepasste Testentwicklung

Eine an die individuellen Bedürfnisse unserer Kunden angepasste Entwicklung neuer Testmethoden bietet die Grundlage für eine schnelle und effiziente Bewertung des jeweiligen Materialverhaltens unter Einsatzbedingungen.
Leistungen:
- Abbildung des Stands der Technik auf Basis von Literaturrecherchen
- Aufstellung von Konzepten für angepasste Testentwicklung
- Aufbau von adaptierten Tests und Verifizierung
- Entwicklung von Methoden zur Fehlerdiagnose und Qualitätskontrolle für die Mikroelektronik
Materialdiagnostik Leistungselektronik
Materialdiagnostik, Fehleranalyse und Qualitätssicherung von Prozessen
Mit Methoden der Materialdiagnostik entwickeln wir ein tiefgreifendes Verständnis für Werkstoffe im Einsatz und unterstützen unserer Partner bei der Entwicklung innovativer Werkstofflösungen und Technologien für die Leistungselektronik. Wir unterstützen unsere Partner bei der Schadensaufklärung und Fehleranalyse an Feldausfällen und Produktreklamationen durch leistungsfähige Fehlerdiagnostik und prozessbezogenes Know-how. Weiterhin bieten wir mikrostrukturbasierte Zuverlässigkeitsanalysen bei der Herstellung von Produkten mit hoher Lebensdauer im Einsatz an. Dazu nutzen wir verschiedene hochaufgelöste Methoden der Mikrostrukturdiagnostik
Leistungen:
- Mikrostrukturdiagnostik
- mechanische Prüfung zur Kennwertermittlung
- FEM-Simulation
- Fehlerlokalisierung und zerstörungsfreie Analyse (SAM, Xray, CT, Lock-In Thermografie)
- effiziente nm-genaue Zielpräparation der Versagensstellen (FIB, Plasma-FIB, Ionenätzen, Laser, Metallographie)
- Mikrostruktur- und Materialdiagnostik (SEM, EDX, WDX, EBSD)
- Nanoanalytik (TEM, TEM-EDX, AFM)
- Oberflächen- und Spurenanalytik (XPS/ESCA, TOF-SIMS, ICP-MS)
- Polymeranalytik (DSC, TGA, DMA)
- umfassende Korrelation der Analyseergebnisse zu den Fehler- und Defektmoden bzw. Struktur-Eigenschafts-Beziehungen
- mechanische Tests, Modellierung, Simulation
3D Röntgenanalytik zur Prozessbewertung bei der Entwicklung und Einführung innovativer neuer Materialien, hier CT- Scan eine leistungselektronischen Moduls mit anorganischer Vergussmasse
Darüber hinaus unterstützen wir unserer Partner mit Methoden Werkstoffanalytik bei der Entwicklung und Qualifizierung von Materialien und Technologien für die industrielle Praxis. Mit unserem weiten Spektrum moderner und optimierter Diagnostikmethoden unterstützen wir außerdem bei der Absicherung einer optimalen Ausbeute in der Serienfertigung.
Optimierung und Entwicklung von Testverfahren
Eine an die individuellen Bedürfnisse unserer Kunden angepasste Entwicklung neuer Testmethoden bietet die Grundlage für eine schnelle und effiziente Bewertung des jeweiligen Materialverhaltens unter Einsatzbedingungen, ohne zu übertesten.
Leistungen:
- Abbildung des Stands der Technik auf Basis von Literaturrecherchen und Erfahrungswerten
- Aufstellung von Konzepten für angepasste Testentwicklung
- Aufbau von adaptierten Tests und Verifizierung
Mikromechanische Prüfung und Simulation
Simulation und Modellierung
Simulationstools bieten die Möglichkeit komplexe Wechselwirkungen im Material sowie im Bauteil besser zu verstehen. Hierbei unterstützen wir unsere Partner bei den folgenden Fragestellungen.
Leistungen:
- Mechanische, thermo-mechanische und multiphysikalische FEM-Simulationen
- Simulation und Anpassung von bruchmechanischen, probabilistischen und ermüdungsbasierten Schädigungsmodellen
- Multiphysikalische Prozesssimulationen
- physikalisch basierte Sub-Modellierung von Fehlermoden
- Designoptimierung bezüglich Zuverlässigkeitssteigerung
- Modelverifikation durch Struktur-Eigenschaftskopplung, Kombination hochauflösende Fehleranalytik oder thermomechanischer Deformationsmessungen auf Bauteilebene
- Kontinuumsmechanik basierte Mikrostruktursimulationen für Materialdesign und Fehleranalytik
Testentwicklung für die Materialcharakterisierung
Eine an die individuellen Bedürfnisse unserer Kunden angepasste Entwicklung neuer Testmethoden bietet die Grundlage für eine schnelle und effiziente Bewertung des jeweiligen Materialverhaltens unter Einsatzbedingungen.
Leistungen:
- Entwicklung kundenspezifischer Tests für Bauteile / Baugruppen
- Testentwicklung zur angepassten Materialcharakterisierung von Werkstoffen
- Experimentelle Nachbildung von Fehlermoden unter kundenspezifischen Belastungsszenarien inklusive Testentwicklung
- Normung und Standardisierung von Testmethoden
Materialcharakterisierung
Eine werkstoffspezifische und anwendungsnahe Materialcharakterisierung bildet die Grundlage für eine ausreichende Genauigkeit von Simulationsanalysen. Entsprechend der Auswahl geeigneter Materialgesetze wird eine komplexe experimentelle Materialcharakterisierung und Parameteridentifikation erforderlich.
Leistungen:
- Durchführung standardisierter und kundenspezifischer Versuche zur Materialcharakterisierung
- Parameteridentifikation von erweiterten Materialparametern für die FEM-Simulation (nichtlineares temperaturabhängiges Materialverhalten, thermophysikalische Charakterisierung)
- Lokale Materialcharakterisierung mittels Nano-Indentation im Sub-Mikrometer-Bereich (inkl. lokale Eigenschaftsmappings E-Modul/ Härte)
- Eigenschaftscharakterisierung dünner und funktionaler Schichten und Schichtsysteme
- Ermittlung von Kenndaten bis in den Hochtemperaturbereich/ Tieftemperatur
Kenndatenermittlung für Versagens- und Schädigungsmodelle
Neben Kenntnissen zu geeigneten Materialparametern, welche eine Berechnung der vorliegenden Belastungszustände ermöglichen, werden Kenndaten zu Schädigungsmodellen erforderlich. Hierfür wird entsprechend der auftretenden Fehlermechanismen eine experimentelle Charakterisierung notwendig.
Leistungen:
- Parameteridentifikation von Versagenskenngrößen und Schädigungsparametern
- Ermittlung bruchmechanischer Kenndaten für Bulkmaterialen und Interface- / Grenzflächen
- Bruchmechanische Charakterisierung von Bondfestigkeiten
- probabilistische Festigkeitsbewertung von Werkstoffen zur Prozessoptimierung und Materialbeschreibung
- Mikromechanische Bestimmung von Ermüdungskenndaten (z.B. LCF, Risswachstumskurven)
- Charakterisierung der Versagenseigenschaften dünner Schichten (z.B. Nano-Scratchtests)
Aufbau- und Verbindungstechnik
Entwicklungsbegleitende Material- und Bauteilcharakterisierung
Eine an die individuellen Bedürfnisse unserer Kunden angepasste Material- und Bauteilcharakterisierung zur schnellen und effizienten Bewertung des Materialverhaltens bereits während der Entwicklung.
Leistungen:
- Analyse chemischer Zusammensetzung
- Ermittlung mechanischer/ elektrischer/ thermischer Materialkennwerte
- Mikrostrukturelle Materialanalysen
- Alterungstests (Degradation unter definierten Belastungen)
Beiträge zur Fertigungs- und Verarbeitungsoptimierung
Wir unterstützen unsere Kunden mit einer schnelle und effizienten Bewertung des jeweiligen Materialverhaltens während der Fertigung.
Leistungen:
- Analyse der Verbindungsqualität (mechanisch/ mikrostrukturell)
- Evaluierung der Prozessierbarkeit
- Zuverlässigkeitsanalyse der Kontaktelemente
- Kontaminationsanalysen der Kontaktbereiche
Analyse von Schadensfällen, Degradationsmechanismen und Ausfallrisiken
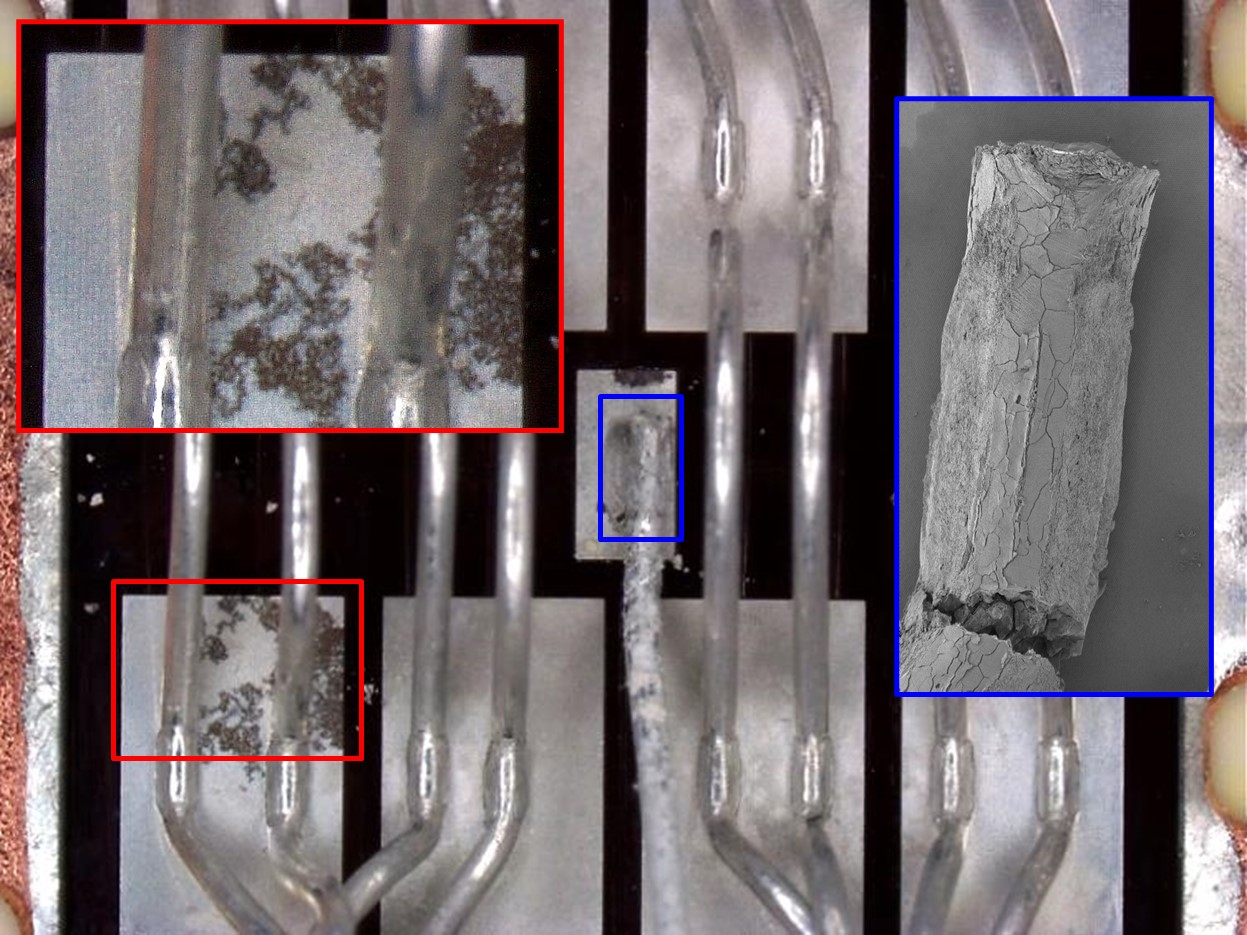
Hier werden defektauslösende Faktoren identifiziert und die entsprechenden Versagensmechanismen nachzuvollzogen. Dies bietet die Grundlage für eine Steigerung der Zuverlässigkeit elektronische Systeme, denn sind diese bekannt, kann ein wirksamer Schutz entwickelt und das Ausfallrisiko minimiert werden.
Leistungen:
- Fehlerlokalisierung (optisch/ elektrisch/ thermisch/ akustisch) und Zielpräparation (Laser/ Ionenstrahl/ metallographisch/ chemisch) auf höchstem Niveau
- Mikrostrukturanalyse bis in atomare Dimension
- Chemische Elementanalyse für alle Aspekte (Oberfläche/ Volumen/ Dünnstschichten/ Partikel)
- Aufklärung des Schädigungsmechanismus und Ableitung von Gegenmaßnahmen sowie Abschätzung weiterer Ausfallrisiken
Simulation und Lebensdauerabschätzung
FE-Simulationen ermöglichen es, Einflüsse von Materialkennwerten, Verbau-Geometrien, Prozessparametern und Belastungsszenarien rechnerisch zu modellieren und erlauben es somit, Optimierungen zu leisten (Material, Prozess, Struktur-Design), Lebensdauerabschätzungen zu treffen und Versagensmechanismen nachzubilden.
Leistungen:
- Simulation von spezifischen Lastfällen (mechanisch/ thermisch/ elektrisch) zur Degradations- und Lebensdauerabschätzung
- Begleitende Simulation zur Bauteilentwicklung (Materialauswahl/ Kontaktgeometrie/ Prozessierbarkeit)
- Inverse Simulation zur Nachbildung von Schädigungsmechanismen und Wirksamkeitsabschätzung von Abstell- bzw. Gegenmaßnahmen
Entwicklung angepasster Test- und Analysemethoden
Weiter- und Neuentwicklungen von Bauteil- und Systemtechnologien erfordern eine kontinuierliche Bewertung, Anpassung oder Neuentwicklung von Test-, Präparations- und Analysemethoden inklusive Verifizierung sowie Definition von Bewertungskriterien. Dazu leisten wir mit unserem ganzheitlichen Portfolio von Material-, Prozess- und Applikationsverständnis in Kombination mit unserem Test- und Analyse-Knowhow sowie Kooperationen mit Anlagen- und Geräteherstellern einen wertvollen Beitrag.
Leistungen:
- Modifizierung sowie Neu- oder Weiterentwicklung von Test- und Analysemethoden/ -geräten (inkl. Bewertungskriterien) entsprechend individueller Anforderungen
- Verifizierung der Validität bestehender Test- und Analysemethoden/-geräten sowie der zugehörigen Bewertungskriterien
Physikalische Fehleranalyse
Lokalisierung von elektrischen Defekten
Für die Identifikation von lokalen Defekten in integrierten Schaltkreisen setzen wir optische, thermische und elektronenstrahlbasierte Fehlerortungsverfahren ein. Dabei werden ICs mit elektrischem Fehlverhalten wie Kurzschlüssen, hochohmigen oder offenen Kontakten oder Abweichungen der Leistungsaufnahme und Funktionalität untersucht und gemeinsam mit dem Kunden entsprechende Fehlerstellen lokalisiert.
Leistungen:
- Kennlinienmessung auf Bauelement- und Einzeltransistorebene mittels lokalem Probing unter dem Lichtmikroskop oder im Rasterelektronenmikroskop (Nanoprobing)
- CMP-Delayering von IC-Strukturen für den Messzugang auf Transistorebene
- REM basierte Potentialkontrast und Stromabbildungstechniken (EBIC, EBAC, EBIV, E-Beam Probing)
- Höchauflösende Lock-in-Thermographie zum Nachweis thermisch aktiver Defekte
- Emissionsmikroskopie zum Nachweis elektrisch aktiver Defekte
- Schaltkreismodifikation und Präparation lokaler Antastpads mittels fokussierender Ionenstrahltechnik (FIB-CE)
Prozesscharakterisierung und Fehlerdiagnostik
Mittels hochauflösender Analyse werden geometrische Prozessabweichungen und Kontaminationen nachgewiesen und entsprechende Optimierungsansätze und Abstellmaßnahmen erarbeitet. An lokalisierten elektrischen Defektstellen werden unter Einsatz von Zielpräparationsverfahren und physikalischer Analytik entsprechende Ausfallursachen und Degradationsmechanismen ermittelt. Dabei werden bei komplexen Ausfallszenarien gemeinsam mit dem Kunden Einsatzbedingungen und Ausfallhistorien ausgewertet, entsprechende Anamnesen erstellt und angepasste Analysestrategien erarbeitet, um die auslösenden Fehlerursachen zu identifizieren und abstellen zu können.
Leistungen:
- FIB/ REM Durchmusterung von lokalisierte Defektstellen zum Auffinden von nm-Defekten
- FIB Zielpräparation von IC-Strukturen und Defekten
- Hochauflösende elektronenmikroskopische Analyse mittels Rasterelektronenmikroskopie und atomar auflösender Transmissionselektronenmikroskopie einschließlich Elementnachweis mittels EDX/ EELS
- Oberflächen- und Spurenanalytik mittels ToF-SIMS und XPS zur Identifizierung von Verunreinigungen in IC-Grenzflächen und auf Kontaktoberflächen
Entwicklung von Analysetechniken
Für die Lokalisierung und Fehlerdiagnostik von elektrischen Defekten werden entsprechende Analyseverfahren an die jeweiligen Erfordernisse angepasst und weiterentwickelt. Ziel ist es, die Nachweisempfindlichkeit und Ortsauflösung für die Defektlokalisierung zu erhöhen und die Präzision und Artefaktfreiheit bei der FIB-Zielpräparation mit Blick auf die stetig kleineren Technologiegrößen zu verbessern.
Leistungen:
- Weiterentwicklung von REM insitu Nanoprobing-Techniken und entsprechenden Präparationsverfahren für den Messzugang
- Elektronenstrahlbasierte Abbildungstechniken für die Lokalisierung elektrischer Defekte in Schaltkreisstrukturen
- Laser- und Plasma-FIB Präparation von großflächigen Querschnitten und gekoppelte Ga-FIB Zielpräparation
- FIB-Trenching für den substratseitigen Messzugang
- Repackaging (Einbringung defekter Bauelemente in neue Testumgebung)
Zerstörungsfreie Defektlokalisierung
Entwicklung und anwendungsspezifisches Design fokussierter akustischer Prüfköpfe
Sensitivität und Abbildungsauflösung sind zentrale Kriterien für die zerstörungsfreie akustische Bildgebung. Aufgrund der Materialien, die sich bei der zerstörungsfreien Inspektion zwischen Prüfkopf und Untersuchungsregion befinden, können diese beiden Parameter jedoch stark kompromittiert sein. Die Lösung bietet hier ein optimal in Frequenz und Fokussierung an die Probe angepasster Ultraschallprüfkopf, der für höchstmögliche Performance bei der ultraschallbasierten Defektlokalisation und Abbildung sorgt.
Leistungen:
- Simulation der transienten Schallausbreitung vom Piezoelement bis in die Probe (und zurück)
- Design und Dimensionierung der fokussierenden Apertur
- Aufbau und Herstellung applikationsoptimierter Prüfköpfe gemeinsam mit kompetenten Partnern
- Akustische Mikroskopie
Entwicklung von Messtechnik und Aufbauten für Akustik und Thermographie
Bei der Analyse von Defekten sind die physikalischen Ursachen der Entstehung von zentralem Interesse. Hier ist die Lokalisation auf makroskopischer und mikroskopischer Ebene unerlässlich, um nachfolgende hochauflösende Analysetechniken zu navigieren. Dabei ist die Erhaltung des Ursprungszustandes der Proben notwendig, um die Defektsituation nicht zu verändern. Je nach Defekttyp (mechanische strukturelle Veränderung, Delamination, elektrischer Kurzschluss / -open, etc.) können hier unterschiedliche Kontrastmechanismen hilfreich sein. Wir passen unsere Messtechnik an die jeweiligen kundenspezifischen Anforderungen an und evaluieren die Anwendbarkeit auf verschiedene Proben- und Defekttypen zum Zwecke der Fehleranalyse und der Qualitätssicherung.
Leistungen:
- Entwurf, Aufbau und Evaluierung zerstörungsfrei arbeitender Messtechnik aus den Bereichen Akustik (Ultraschall), Thermographie und der magnetfeldsensitiven Sensorik
- Evaluierung von Lock-In Thermographie, Akustischer Mikroskopie oder Magnetfeldmikroskopie für Fragestellungen zur zerstörungsfreien Defektlokalisation
Softwareseitige Implementierung der Hardware
Die, mit der entwickelten Messtechnik akquirierten Daten liegen häufig in Form zeitsignalbasierter Datensätze oder von Bildstapeln vor und haben üblicherweise eine komplexe Struktur und einen großen Umfang. Zur Steuerung der Messtechnik und zum Handling der Daten muss die Hardware eines entwickelten Messaufbaus softwareseitig implementiert werden. Dies schließt sowohl die Kommunikation mit der Hardware und deren Steuerung ein, als auch das zeitkritische Handling der anfallenden Daten.
Leistungen:
- Softwareseitige Implementierung zur Realisierung der Kommunikation mit der Hardware zur Gerätesteuerung
- Softwareimplementierung zur Steuerung der Datenakquise und zeitkritisches Handling der Daten
Entwicklung von Signal- und Datananalysemethoden inklusive Software
Im Workflow schließt sich hier die Verarbeitung der Daten zum Zwecke der Analyse an. Unser Team entwickelt auf die jeweilige Fragestellung bezogene Methoden zur Signalanalyse, um die der Fragestellung entsprechend relevante Information zu extrahieren. Hier kommen insbesondere auch Methoden der maschinellen Datenanalyse - speziell des Deep Learning - zum Einsatz, die Interpretationssicherheit und somit die Zuverlässigkeit der gesamten Analyse erhöhen. Die entwickelten Algorithmen werden in Anwendersoftware kombiniert.
Leistungen:
- Algorithmen und Methodenentwicklung der klassischen Signalanalytik
- Entwicklung von Analysekonzepten auf Basis des Maschinellen Lernens
- Implementierung in Anwendersoftware
GaN-HEMT-Bauelemente
Prozess- und Technologiecharakterisierung
Mittels hochauflösender Analyseverfahren werden GaN-EPI Schichtsysteme und GaN-HEMT-Strukturen untersucht, um Schichtdicken und Eigenspannungen zu ermitteln, Defektdichten zu bestimmen und Oberflächen- und Grenzflächenkontaminationen zu identifizieren. Damit unterstützen wir unsere Partner bei der Entwicklung bei der Entwicklung und Optimierung von GaN-EPI-Prozessen und funktionaler HEMT- Strukturen auf verschiedenen Substraten.
Leistungen:
- Hochauflösende elektronenmikroskopische Analyse der GaN-EPI- Schichtstrukturen und Kristalldefekte mittels (S)TEM/ EDX
- Analyse der Gitteranpassung und Eigenspannungen in GaN-EPI-Schichten mittels Elektronenstrahlbeugung (NBED)
- Nachweis von prozessbedingten Verunreinigungen auf Substratoberflächen und in Schichtgrenzflächen zu Gate- und Ohm-Metallkontakten und Passivierungen
- Nachweis und Quantifizierung von Dotierungen in p-GaN mittels ortsaulösender Spurenanalytik (TOF-SIMS)
Fehlerdiagnostik und Aufklärung von Fehlermechanismen
Wir untersuchen gezielt gestresste und ausgefallene GaN-HEMT -Bauelemente, um neue technologiespezifische Fehlermodi und Ausfallursachen und Degradationsmechanismen zu ermitteln. Ziel ist es dabei, design- oder prozessbedingte Schwachstellen in den GaN-HEMT- Strukturen zu identifizieren und die Technologien entsprechend weiterzuentwickeln.
Leistungen:
- Lokalisierung elektrisch aktiver Defektstrukturen in GaN-HEMT- Strukturen mittels Elektrolumineszenz-Mikroskopie und hochauflösender Lock-in-Thermographie
- Lokalisierung kritischer Defekte in der GaN-EPI mittels elektronenstrahlbasierter Stromabbildung (REM-EBIC)
- Präzise Zielpräparation von Defektstellen mittels fokussierender Ionenstrahltechnik und Analyse der Defektstrukturen mittels atomar auflösender analytischer Elektronenmikroskopie zur Identifikation und Ursachenermittlung von stress- und einsatzbedingten Degradationsmechanismen
Weiterentwicklung von Analysemethoden
Wir entwickeln Analysemethoden für die zielgenauere und effizientere Lokalisierung von Defektstrukturen. Für den Nachweis von Defektmechanismen und Fehlermodi in GaN-EPI und GaN-HEMT-Strukturen entwickeln wir unsere Analyseverfahren zur exakten Lokalisierung elektrisch aktiver Defekte, zur Zielpräparation und hochauflösenden Strukturanalyse ständig weiter.
Leistungen:
- Front- und waferrückseitige Lokalisierung und Identifizierung von elektrisch aktiven Defekten mittels Elektrolumineszenz-Spektroskopie und Lock-in-Thermographie
- Elektronenstrahlbasierte Abbildungstechniken für pn-Übergänge und den Defektnachweis in der GaN-EPI (EBAC, EBIC, ECCI)
- Hochauflösendes Mapping von Kristallgitterparametern und entsprechenden Abweichungen mittels Nanoelektronenstrahlbeugung (NBED) im STEM
- Hochauflösende TOF-SIMS-Analytik für den Nachweis und die Quantifizierung von Dotierelementen und Wasserstoff in GaN-EPI Strukturen